Products
製品情報
半導体製造装置関連
クリーンルーム(クラス5000対応)を完備し半導体前工程用製造装置関連の製造を多く手掛けております。
- 枚葉アッシング装置
- 枚葉プラズマ窒化・酸化装置
- 枚葉アニール装置
- バッチ式成膜装置
- プラズマ真空装置
- プラズマCVD装置
- プラズマエッチング装置
- 有機ELディスプレイ装置
インフラ関連
- ダム系監視操作表⽰器
- ダム⽔位、放流監視システム
- 新幹線装置盤
- シュルター配電盤
- 放送局向けシミュレータ
- デジタル放送装置
⾞載⽤試験装置関連
- 制御系ユニット
- 操作系ユニット
- 変換ユニット
バッチアッシング装置
半導体ウェーハプロセスにおいてウェーハ上に回路を作るマスクとして使用するフォトレジストを剥離する装置です。
用途に合わせてお選びいただけます。
ウエハサイズは150mm、200mmに対応しています。
-
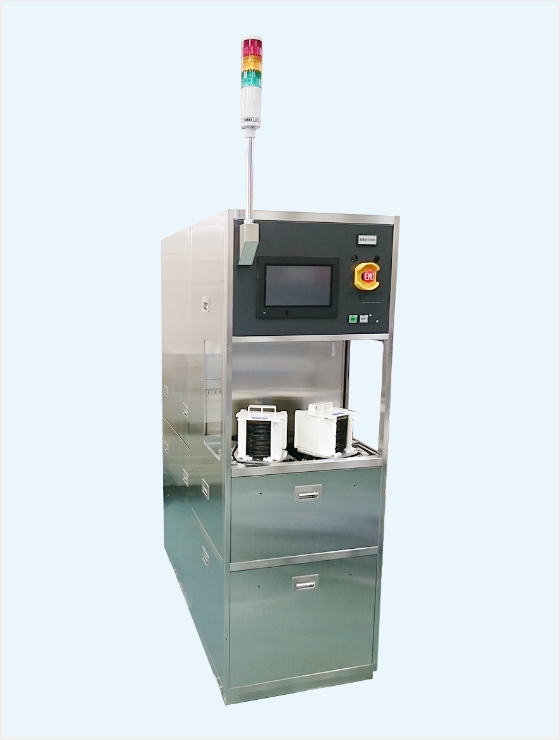
MG6500R
-

MG8500R
-

MG200
製品の特徴
- 省フットプリント機能
- 制御ラックユニットのコンパクト化によるコスト改善が可能
- Ethernetを採⽤したノイズ対策強化や省配線化などの通信系統の改良化
- 搬送系新規オリジナル設計による、直動式シングルアーム型の搬送ロボットの最適化
- PLC制御を採によるPCモデルチェンジ収束問題、HDD故障の回避
- ハイスループット
- 低ダメージプラズマアッシングシステムの実現
製品詳細
横にスクロールできます
| MG6500R | MG8500R | MG200 | |
|---|---|---|---|
| 処理ウエハーサイズ | 150㎜(6インチ)、オプション125㎜(5インチ)兼用可 | 200mm(8インチ) | |
| 処理方法 | 同軸パレル方式 | 枚葉式 | |
| RF電源 | 1kW 13.56MHz オートチューニング | 2kW 13.56MHz オートチューニング | 3kW 27.12MHz |
| プロセスガス | O2 | ||
| パージガス | N2 | ||
| 処理ステップ | 3ステップ(128レシピ) | 20ステップ(100レシピ) | |
| チャンバ数 | 円筒・縦型x1 | 2 | |
| ウェハー搬送ユニット | 垂直動作 カセットエレベータ 2フィンガ吸着式クリーンロボ |
カセットローダ(SMIForOPEN) 25フィンガー大気搬送 2フィンガ―真空搬送ロボ |
|
| スループット | >50枚/H | >100枚/H | |
| 弊社評価標準ポジレジスト | |||
| t=1.0um | t<2.4um | ||
| ユーティリティ |
電源:Φ3 200V 真空ポンプ:10,000L/min O2:0.2MPa, N2:0.3MPa CDA:0.5MPa フィンガ吸着:-80~-60KPa |
電源:Φ3 200V 真空ポンプ:10,000L/min O2:0.2MPa ,N2:0.3MPa CDA:0.5MPa フィンガ吸着:-80~-60KPa 冷却水:6L/min以上 0.5MPa以下 |
電源:Φ3 200V 真空ポンプ: ・プロセスチャンバ 5,000L/min x 2台 ・ロードロックチャンバ 1,400L/min x1台 O2:0.1MPa, N2:0.1MPa CDA:0.5MPa 冷却水:13L/min以上 0.5MPa以下 |
| 本体寸法(mm) | 600Wx1300Dx1780H | 850Wx1200Dx1950H | 980Wx2058Dx1910H |
| 制御ラック寸法(mm) | 550Wx650Dx745H | 550Wx650Dx835H | 503Wx432Dx1448H |
| 重量(kg) | 300(本体)、120(制御ラック) | 500(本体)、120(制御ラック) | 1300(本体)、100(制御ラック) |
